應用於下一代高密度互連基板的微孔電鍍添加劑
高密度互連基板中的微孔在系統集成中有著很多優勢,例如性能改進和產品微型化。在銅電沉積製造高密度基板中的微孔時, 電鍍添加劑的使用最為重要。現時只有少數電子材料公司能提供先進新型的添加劑並且獲利率極高。隨著現今先進電子產品微型化和多功能化的趨勢,對下一代微孔(<75微米)製造提出了更高的電鍍技術要求,包括更薄的表面沉積層和更小的凹坑,因此市場上極需要新型電鍍添加劑。
基於機理性電鍍仿真軟件的研發,應科院開發了一套快速篩選電鍍添加劑的方法,用來縮短材料開發時間和減少開發成本。通過此方法,應科院成功研發了一系列具有精密分子分佈的新型電鍍抑製劑,以及具有更小質荷比及均衡功能組的新型電鍍整平劑,電鍍表現更勝於現有的商用添加劑,以滿足下一代微孔製造的更高要求。
特點
- 微孔中凹坑深度不大於5微米; 銅厚度薄至10微米
- 高T / P性能的通孔填充
- 優良的附著力、均勻性和可靠性
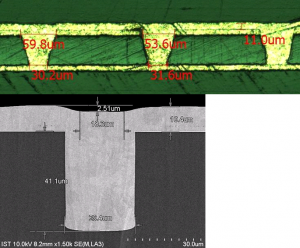
應用
- 應用於先進電子設備的高密度、多層、超薄互連基板(例如智能電話、穿戴式電子產品等)
- 應用於高I/O和高速芯片的微間距IC基板(包括微處理器、存儲芯片等)

應用於下一代高密度互連基板的蝕刻添加劑
近年來,高密度互連基板日益精細的線寬、圖形要求,使得半加成法(SAP)和改良式半加成法(MSAP) 取代傳統的減成法成為主流電路製造技術。然而,SAP和MSAP技術仍面對很大的挑戰及有很大的提升空間。其中兩個挑戰性的步驟便是MSAP技術中在完成電路及移除銅籽晶層時採用的差分蝕刻工藝。
應科院研發了一種解決上述問題的創新方法,即利用新型蝕刻添加劑來克服精細電路中,蝕刻狹窄及高縱橫比溝道時的嚴重底切(undercut)問題。新型的護岸劑(banking agent)可提高溝道側壁高的蝕刻速率。加速劑亦將被加入在溝道蝕刻中用以加快蝕刻速度,以及與護岸劑一起發揮作用減小底切現象。另外,應科院的最新微通孔及微盲孔的電沉積配方可迎合市場上多個電沉積方案的需求,連同蝕刻添加劑的研製及相關工藝可廣泛應用於高密度互連相關應用。
特點
• 可用於精細電路蝕刻包含雙氧水及硫酸制的閃存蝕刻劑
• 適用於SAP / MSAP工藝
• 線位/虛位可以達到15微米/15微米
• 高蝕刻因子,沒有底切問題
• 短蝕刻時間,高蝕刻速率
• 良好的表面形狀和均勻性
應用
• 應用於先進電子設備的高密度、多層、超薄互連基板(智能電話、穿戴式電子產品等)
• 應用於高I/O和高速芯片的微間距IC基板(微處理器、存儲芯片等)